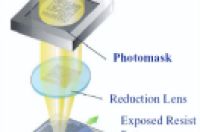
近日,国产光刻机厂商上海微电子在之前90nm的基础上,宣布即将量产28nmimmersion式光刻机,在2023年交付国产第一台SSA/800-10W光刻机设备。
immersion式光刻机就是浸没式光刻机,采用ArF光源,也就是193nm波长的光源,这是第四代光刻机,这也标志着中国和ASML在光刻机上仅有1代的差距,上海微电子凭借此项制程工艺也将会直接赶超日本佳能、尼康厂商,成为继荷兰ASML后,全球第二先进的光刻机厂商巨头。
光刻机的发展
光刻机发展这么久,最主要的还是所使用的光源的改进,每次光源的改进都显著提升了光刻机的工艺制程水平,以及生产的效率和良率。
目前来说,光刻机共经历了五代的发展,从最早的436波长,再到第二代光刻机开始使用波长 365nm i-line,第三代则是 248nm 的 KrF 激光。第四代就是 193nm 波长的 DUV 激光,这就是著名的 ArF 准分子激光。
不过在最开始的时候,193nm 波长的 DUV 激光所制造的光刻机叫做步进扫描投影光刻机,最多只能制造65nm芯片,当时的光刻机巨头还是尼康,业内就想直接研发第五代光刻机,当时大多数人都认为使用157nm波长作为第五代光刻机光源。(尼康当时直接想超长发挥,选用未来技术,也就是0.004nm,然而这个技术难度太过于先进了,现在也没有办法实现)
当时正处于美日光刻机大战时期,这是怎么回事呢?光刻机技术源自于美国,一开始的光刻机巨头是美国的GCA,后来尼康超越了GCA,成为了新的光刻机巨头,80年代中期日本半导体产业成为全球市场的龙头,美国发动芯片战争想要击垮日本半导体产业。(95年美国在这场战争中取得了全面胜利)
90年代的时候,ASML开始在光刻机市场崭露头角,由此成为了美国的扶持对象,当时入股ASML的包括英特尔、台积电、三星等企业。
台积电的林本坚就发现157nm波长的光是无法通过水的。而如果193纳米光在水里折射之后,波长变成132nm,比大家研究的157nm还要短,可以把解析度提高46%,就直接跳过了现157nm波长。
所以他提出在晶圆光刻胶上方加 1mm 厚的水。水可以把 193nm 的光波长折射成 134nm,这就是浸没式光刻机,也就是第四代光刻机的Pro版本。
当时ASML凭借林本坚的方案成功打败了尼康,成为了光刻机市场的龙头,第四代浸没式光刻机是无法制造7nm芯片的。
第四代浸没式光刻机通过多重曝光可实现7nm
但是为了追求更高的图形密度和更小的工艺节点,在普通的涂胶-曝光-显影-刻蚀工艺的基础上开发了多重曝光技术,如LELE(litho-etch-litho-etch)、SADP(self aligned double patterning)。LELE技术将给定的图案分为两个密度较小的部分,通过蚀刻硬掩模,将第一层图案转移到其下的硬掩模上,最终在衬底上得到两倍图案密度的图形;SADP技术通过沉积和刻蚀工艺在心轴(mandrel)侧壁上形成间隔物,经由额外的刻蚀步骤移除心轴,使用间隔物定义最终结构,使得特征密度增加了一倍。将SADP加倍可以得到四重图案化工艺(SAQP),使得193nm浸润式光刻可以实现~10nm的分辨率。
理论上193nm光刻机是可以实现7nm节点工艺制程的,但是会使得需要的光罩数量非常多,工艺复杂,量产难度大。应当指出,即使导入EUV,也并不是所有流程均由EUV承担,主要是应用在MOS器件关键层,其它对关键尺寸要求不高的步骤将仍由普通光刻机承担。
中国第四代浸没式光刻机有望交付
而此次上海微电子研发的SSA/800-10W光刻机设备正是属于第四代浸没式光刻机。
单次曝光就只可以直接生产28nm芯片,如果使用套刻精度在1.9nm左右的工作台,在多次曝光下能够实现11nm制程工艺的芯片生产。如果改用套刻精度更优的华卓精科工作台(1.7nm),在多重曝光下更是能够实现7nm制程工艺的芯片生产。
一旦可以制造7nm芯片,就可以解决半导体产业大部分的需求,因为芯片制造6大设备,扩散炉、刻蚀机,离子注入设备、薄膜生长设备、抛光机和清洗剂,中国目前都处在主流水平,其中刻蚀机更是达到了5nm,可以完成7nm芯片的制造需求。
而目前光刻机材料如电子特气、光刻胶等也在加速国产化,南大光电目前已经可以生产出7nm的光刻胶,当然,在EDA工具、IC设计上中国依然和国外有较大差距。
EUV光刻机研发进度
而在最艰难的第五代光刻机,则由长春光机所来进行研发,2008年国家“极大规模集成电路制造装备及成套工艺”科技重大专项将EUV光刻技术列为“32-22nm装备技术前瞻性研究”重要攻关任务。
长春光机所联合中国科学院光电技术研究所、中国科学院上海光学精密机械研究所、中国科学院微电子研究所、北京理工大学、哈尔滨工业大学、华中科技大学开展了“极紫外光刻关键技术研究”项目研究工作。
长春光机所90年代就已经开始预研EUV技术,2017年, 长 春光机所承担的国家科技重大专项项目“极紫外光刻关键技术研究”顺利通过验收,突破了制约我国极紫外光刻发展的超高精度非球面加工与检测、极紫外多层膜、投影物镜系统集成测试等核心单元技术,成功研制了波像差优于0.75 nm RMS 的两镜EUV 光刻物镜系统,构建了EUV 光刻曝光装置,国内首次获得EUV 投影光刻32 nm 线宽的光刻胶曝光图形,建立了较为完善的曝光光学系统关键技术研发平台。
不过,一台 EUV 光刻机重达 180 吨,超过 10 万个零件,需要 40 个集装箱运输,安装调试都要超过一年时间。如此多的零件,一个国家想要完成,难度实在太大,国家目前打算在2035年之前实现EUV光刻机量产。
可以说,此次上海微电子能够在年底量产28nm的immersion式光刻机。不仅能够解决芯片代工被限制的问题,打破国外厂商的对于IC前端光刻机市场的垄断,而且能够覆盖更为广阔的市场需求,促进国产半导体行业的发展。




